Semi Automatic Wafer CMP Machine
The CMP equipment is designed for high-precision planarization of semiconductor wafers. It features a partitioned air-bag polishing head that ensures uniform pressure distribution across the wafer surface, improving polishing consistency. The EPD system (Endpoint Detection System) precisely controls the material removal rate, enabling accurate thickness reduction throughout the process. Additionally, the equipment is equipped with an automatic dressing system that ensures continuous tool conditioning for optimal performance. To further enhance processing quality, the wafer deionized cleaning system efficiently removes residues, ensuring the wafer is clean and ready for subsequent processes.
Engineering Intents
Automatic wafer loader and cleaner for safe handling
Water-chilling system for temperature control of polishing discs
Oscillating and multi-pressure-zone platen for uniform polishing
EPD detection system for ultra-thin thickness control
Deionized cleaning after polishing
Automatic dressing unit for disc conditioning
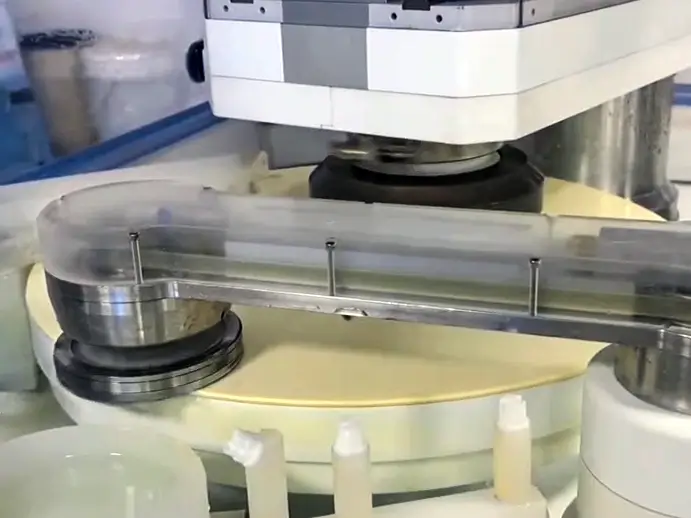
Specifications
| Machine Model | Unit | PDS460AEW | PDS610AEW | PDS910AWE |
|---|---|---|---|---|
| Lapping (Polishing) Disc Diameter | mm | 460 | 610 | 910 |
| Max. Clamping Diameter | mm | 150 | 200 | 300 |
| Number of Workstations | set | 1 | ||
| Disc Rotation Rate | rpm | 5 – 120 | 5 – 100 | |
| Platen Rotation Rate | rpm | 0 – 80 | ||
| Platen Oscillating Stroke (Twin Platen) | mm | 112.5π | 143.75π | 193.75π |
| Platen Reciprocate Stroke | mm | 55 | 80 | 130 |
| Platen Feed Stroke | mm | 120 | ||
| Platen Air Bag Pressure | psi | 0.5 - 12 | ||
| Disc Dresser Oscillating Storke | mm | 130.5π | 161.25π | 211.25π |
| EPD Wavelength | nm | 360 – 1100 | ||
| Temperature Control Tolerance | °C | ± 2 | ||
| Main Motor | kVA | 8 | 12 | 17 |
| Total Weight | kgf | 1950 | 2400 | 2850 |
| Dimension (W×D×H) | mm | 1500×1650×2100 | ||
- All datas are subject to change without notice. Please verify details with Dyan.
Features
1. Disc Temperature Control System
Temperature Control System (DSTC) is designed to monitor and manage the temperature of the disc surface, on the touch screen. Learn More
2. Oscillating Platen
The oscillating platen (the process) facilitates a sequential, spiraling, cross-path processing route for the workpiece, resulting in exceptionally good flatness. Learn More
3. Air Bag Platen (P-ABP)
Ponda’s air bag platen distributes pressure across the wafer surface in up to 6 distinct zones, allowing for precise control of planarization forces. Learn More
4. Automatic Disc Dressing System

The automatic dressing system conditions the abrasive surface of the polishing pads, ensuring consistent cutting efficiency and extending tool life. By precisely controlling the dressing process, it eliminates the need for manual intervention, reducing the risk of contamination. This feature guarantees that the equipment delivers high-quality results and maintains stable performance throughout the production cycle.
5. Wafer Deionized Cleaning System
The wafer deionized cleaning system uses high-purity deionized water to thoroughly remove chemical contaminants and particles from the wafer’s surface, without introducing ionic impurities that could affect the wafer’s quality. This cleaning process also prevents the crystallization of chemicals on the wafer’s surface, ensuring optimal cleanliness for subsequent processing.
6. End Point Detector (EPD)
In-process end-point detectors are essential in chemical mechanical planarization (CMP) processes, actively monitoring the procedure in real-time. They specifically utilize variations in light emission, such as intensity or spectrum changes, to accurately signal the completion of the polishing layer. Learn More
Model Defination

| PDS | Single Sided Wafer Lapping & Polishing Machine |
| 460 · 610 · 910 | Polishing Disc Diameter |
| A | Air Bag Platen |
| E | EPD System |
| W | Platen Oscillation |
- For multiple models with similar appearances, only a single model figure will be displayed.
Get us in touch
- If you’re unsure which equipment best suits your needs, we’re here to help.
Why partner with us?
Partnering with us means gaining access to reliable, precision-engineered grinding and polishing solutions. With extensive industry experience and a commitment to quality, we provide expert support and equipment tailored to meet your specific needs.
Follow us on social media
How to choose the right equipment
- We offer insights into the equipment's performance across various use cases.
- Discover how our grinding and polishing machines are used across various industries.
- If you’re unsure which equipment best suits your needs, we’re here to help.
